薄膜压电MEMS代工
承接开发和量产工作
主要技术和服务
包括使用了硅晶圆和SOI晶圆等的MEMS器件的工艺规划、高性能压电薄膜的生产制造、压电MEMS器件的代加工和设计支持等在内,罗姆可提供从试制、开发到量产的全程支持。即使想了解罗姆官网和产品目录中未列出的个别工艺,也欢迎随时联系。

量产和开发生产线
在蓝碧石半导体宫崎工厂,罗姆建设了将自有薄膜压电技术与LSI生产线相融合的6英寸MEMS生产线。
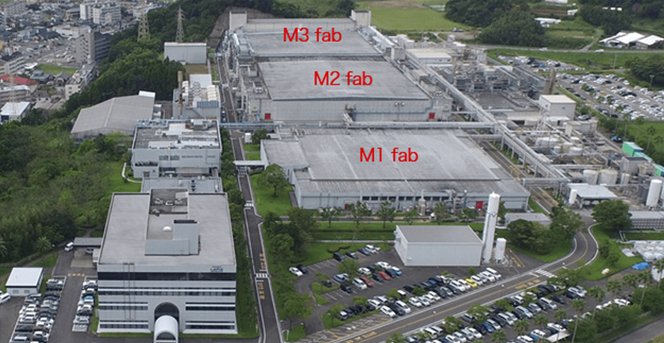
| 位置 | 宫崎县宫崎市清武町 |
|---|---|
| 无尘车间 | 压电MEMS专用部分 1,360m2 |
| 清洁度等级 | Class 1-1,000 |
| 晶圆直径 | 6英寸 |
| 提供的服务 | 开发样品试制、量产 |
| ISO等 | ISO9001, ISO14001 |
| 开发和量产经验 | 执行器、传感器 |
| 工艺技术 | PZT压电薄膜、双面Si加工、晶圆键合 |
从客户咨询到量产的流程
用专用MEMS生产线进行代工生产,支持从产品试制到量产的整个过程!

*以上流程为通常流程示例,实际流程将根据每个项目具体协商确定。
如需咨询、委托或提出要求,请随时填写咨询页面上的表格与我们联系。
拥有的设备
通过在生产线上配备MEMS工艺所需的设备和分析工具,能够为各种器件提出工艺建议并实现品质提升。
| 工艺分类 | 设备 |
|---|---|
| 成膜 | |
| 溶胶-凝胶(PZT类) | |
| PE-CVD (SiO2、SiN) | |
| LP-CVD (SiO2、SiN、poly-Si) | |
| 热氧化炉 | |
| 溅镀(Pt、Ir、IrO2、AlCu、Ti、TiN 等) | |
| ALD(Atomic Layer Deposition) (Al2O3、SiO2、Ta2O5) |
|
| 防水涂层成膜 | |
| 光刻 | |
| 涂覆、显影 | |
| MPA (Mirror Projection Aligner) | |
| 双面校准器、IR步进机、i-line步进式光刻机 | |
| 干刻蚀 | |
| 深硅刻蚀 | |
| 层间膜RIE装置 | |
| PZT和电极用的ICP刻蚀机 | |
| 湿刻蚀 | |
| 硅氧化膜刻蚀 | |
| Au离子刻蚀 | |
| 硅各向异性刻蚀 | |
| 晶圆键合 | |
| 树脂键合 | |
| 阳极键合 |
| 工艺分类 | 设备 |
|---|---|
| 减薄 | |
| 全自动晶圆贴膜机 (UV胶膜、热剥离膜、聚酰亚胺膜等) |
|
| 剥离、清洗 | |
| 灰化 | |
| 有机物、聚合物剥离 | |
| 酸洗、清洗机 | |
| 划片等 | |
| 切割、二流体清洗 | |
| 晶圆切割机(Circle Cut Dicer) | |
| 计量相关 | |
| 分析SEM、测长SEM、离子铣削 | |
| 光学测长仪 | |
| 偏差测量仪 | |
| 可见光/红外光/激光显微镜 | |
| X射线衍射仪 | |
| 激光式位移测量装置 | |
| X射线荧光分析仪 | |
| 接触式台阶仪、光学干涉仪 | |
| 椭偏仪 | |
| 自动外观检测设备(支持正反面穿透晶圆) | |
| 各种电气特性评估装置 (探针台、测试仪) |
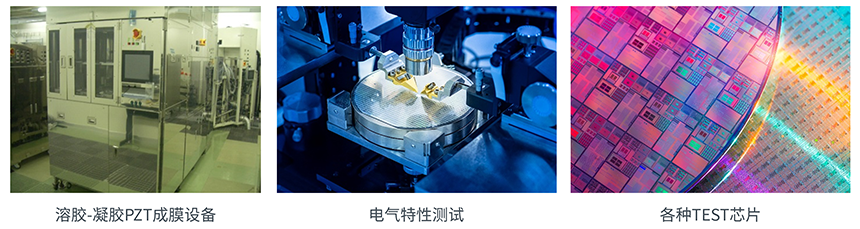
工艺能力
即使想了解罗姆官网和产品目录中未列出的个别工艺,也欢迎随时联系。
| 工序 | 工艺规格 | 数值 | 备注 |
|---|---|---|---|
| 光刻 | 最小线宽(使用步进器) 最小线宽(使用校准器) |
1μm 3μm |
|
| 深硅刻蚀 | 侧壁刻蚀倾斜度 刻蚀速率面内均匀性 尺寸精度 |
90±1度 ≤5% ±0.1μm (均取决于Pattern) |
可进行电路板过孔加工 可进行正反两面加工 (无缺口) 可进行侧壁蚀刻倾斜度控制 |
| TMAH刻蚀 | 深度 | ≤面内5% | 可进行电路板过孔加工 可进行正反两面加工 |
| PZT成膜 | 膜厚精度 | 晶圆内 ±1.0% 晶圆间、批次间 ±2.5% |
掺杂示例(Nb、La) |
| PZT刻蚀 | 加工线宽精度 刻蚀速率面内均匀性 |
±1μm ≤5% (PZT厚度~3μm,有侧壁刻蚀倾斜度) |
支持Pt Stop |
| 溅镀 | 膜厚均匀性 | ≤面内4% | Pt、Ir、IrO2、AlCu、Ti、TiN 等 |
| CVD | 膜厚均匀性 | ≤面内4% | SiO2、SiN |
| ALD | 膜厚均匀性 | ≤面内5% | Al2O3、Ta2O5、SiO2 |
| 树脂键合 | 对准精度 树脂厚度 |
±5μm 1~3μm |
环氧树脂、BCB |
| 阳极键合 | 密封内部压力 | >0.01Pa | 硅/玻璃 |
试制和量产业绩示例
基于罗姆在喷头领域的量产业绩和对MEMS技术的钻研,罗姆目前正在与客户联合开发和试制评估小型、低功耗和高位移执行器产品。
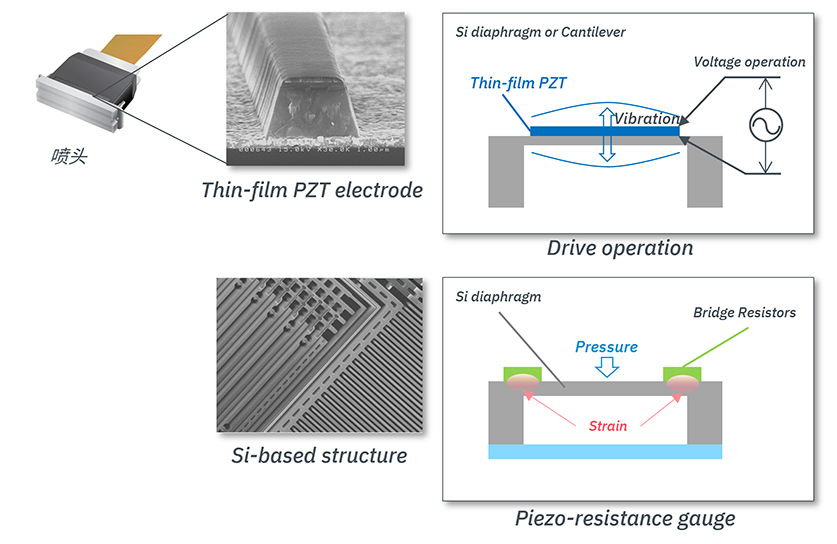
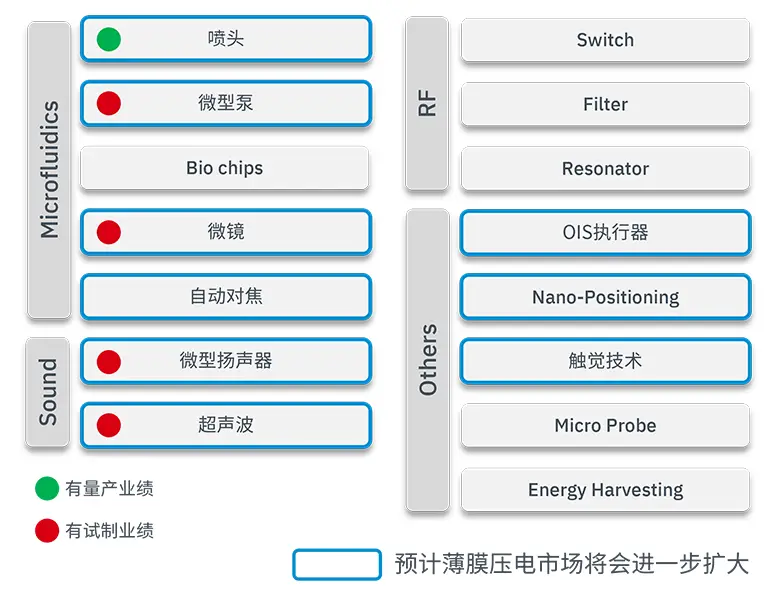
工艺技术示例
PZT薄膜的性能
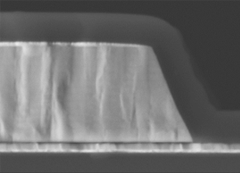
【PZT stack截面】
罗姆于1998年在全球率先成功实现铁电存储器的量产。
在对硅晶圆使用PZT薄膜方面,拥有多年的经验和技术积累。
罗姆提供的溶胶-凝胶PZT膜是使用自行研发的生产设备成膜的,可实现世界超高水准的压电性能和可靠性。
| 项目 | 值 | 条件 |
|---|---|---|
| 压电常数:e31,f (-C/m2) | 19 | 10V/μm |
| 逆压电常数:d31 (-pm/V) | 260 | 10V/μm |
| 介电强度:(V/μm) | >75 | 室温 (受评估电源影响) |
| 绝缘寿命:(年) | >10 | 20V/μm, 105℃, (通过加速试验估算) |
| 循环寿命:(次) | >1x1010 | 10V/μm, 位移减少10% (单极脉冲) |
| 漏电流密度:(A/cm2) | <1x10-7 | 20V/μm |
晶圆级键合技术

【晶圆键合截面】
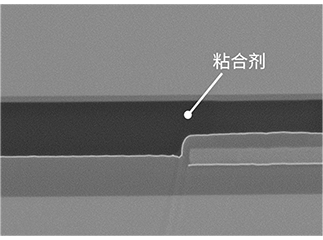
【晶圆键合截面/台阶上】
罗姆拥有多种硅晶圆键合技术,即使是结构复杂的器件也可以进行晶圆级键合。
*可提供粘合剂涂覆和键合工艺解决方案。
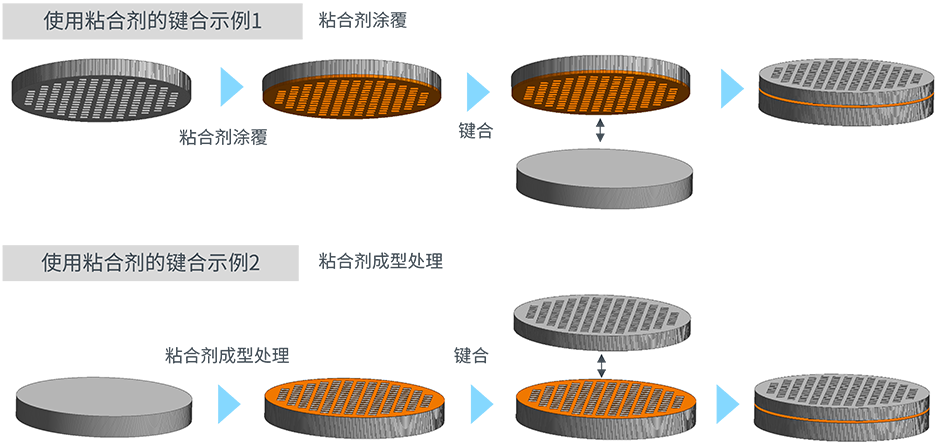
深硅刻蚀

【400μm Si贯穿】

【硅晶圆加工】
罗姆拥有多家公司的硅深刻蚀设备(包括自行开发的设备),可为产品提供最佳的硅刻蚀工艺(形状、公差、异物水平、成本)解决方案。
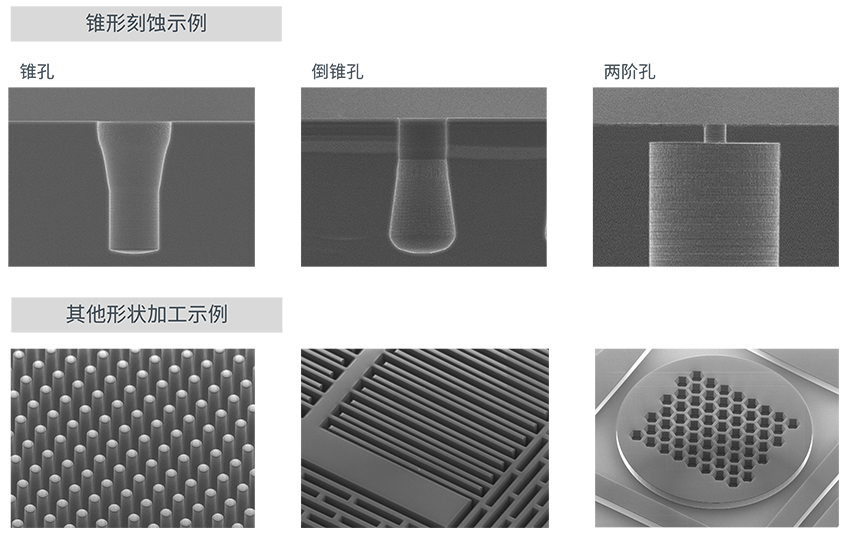
薄晶圆处理技术

【薄硅晶圆】
罗姆自行开发了晶圆运输设备,支持薄硅晶圆相关的工艺和晶圆键合。
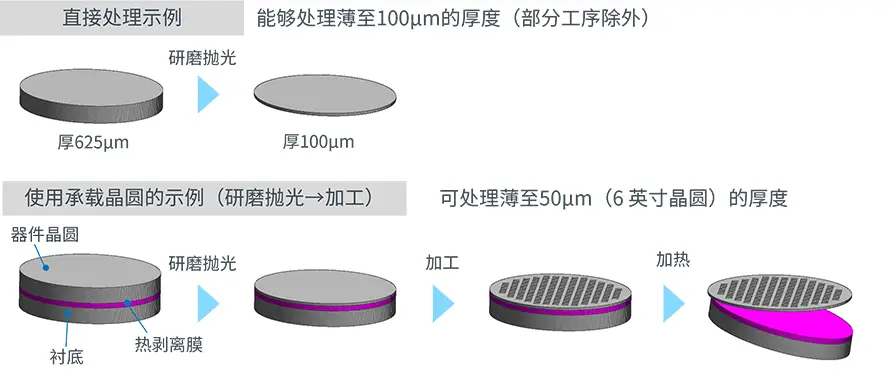

【TAIKO磨削晶圆】

ALD保护膜形成
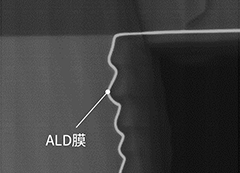
【硅形状截面】
即使在有复杂凹凸形状的器件上,也可以利用*ALD形成均匀的保护膜。
*ALD:Atomic Layer Deposition(原子层沉积)
保护膜:保护设备免受外部因素(Ink、接触造成的磨损、带电等)的影响。
单击此处查看ALD成膜的详细介绍 -电子小百科
压电器件的仿真分析

【硅悬臂梁截面】
罗姆可以对压电器件进行有限元仿真,并为各种器件提供优化的结构和工艺解决方案。